Struktur von Siliziumkarbidoberflächen
Für das Wachstum von Siliziumkarbid für elektronische Bauelemente ist die atomare Struktur der Oberflächen von entscheidender Bedeutung. Ebenso sind Metallfilme auf den SiC von Wichtigkeit für die Kontaktierung der Bauelemente oder zur Herstellung von Schottkydioden.
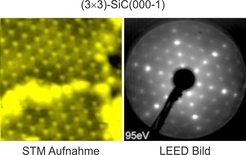
Die Struktur solcher SiC-Oberflächen wird in unserer Arbeitsgruppe untersucht. Wir benutzen die Rastertunnelmikroskopie (STM) und die Beugung langsamer Elektronen (LEED), um Informationen über die Positionen der Atome an der Oberfläche zu gewinnen. Mit dem STM kann die Realraumstruktur der Probenoberfläche analysiert werden. Wie Sie in der unten abgebildeten Aufnahme sehen können, gelingt dies bei SiC mit atomarer Auflösung. Aus den LEED-Beugungsdaten kann die vollständige kristallographische Struktur auch tieferer Lagen auf wenige Hundertstel Ångstrøm genau bestimmt werden. Dazu werden Serien von Beugungsbildern der unten abgebildeten Art mit dem Computer aufgenommen und daraus die Intensitäten der Beugungsreflexe ermittelt. Die Strukturanalyse wird in Zusammenarbeit mit Theoriegruppen am Institut oder extern durchgeführt. Zusätzliche Informationen über Stöchiometrie und die chemischen Bindungsverhältnisse gewinnen wir aus röntgenangeregter Photoelektronenspektroskopie (XPS) und Augerelektronenspektroskopie (AES).
